半導體材料在晶體生長和制造過程中,由于各種原因會出現缺陷、應力等問題,進而影響半導體器件的性能。通過退火處理,可以使半導體材料內部排列更加有序,改善晶體內部結構,消除應力,修復離子注入損傷,促進雜質的合理分布等,從而提高半導體器件的可靠性。
傳統的爐管退火工藝因升溫速率緩慢,加熱時間長,晶片在長時間受熱的情況下會出現雜質擴散嚴重等問題。隨著芯片制造技術的不斷進步,對退火工藝的要求也越來越高,RTP快速退火爐的競爭優勢越來越明顯:具有獨特的水平均溫處理技術,在退火過程中,不僅能在極短的時間內實現升溫和冷卻,提升晶圓退火的效率和效果,還能同時保證晶圓表面的溫度分布均勻性和穩定性,總體熱預算較低,可以更好地提高晶圓的性能,滿足先進半導體的制造需求。
另外,快速熱退火系統具有靈活性和可拓展性,根據不同材料的退火工藝需求進行靈活調整,晟鼎全自動雙腔RTP快速退火爐標配兩組氣體,可拓展至6組工藝氣體,滿足不同材料的熱處理需求,具有靈活性和可拓展性。

全自動雙腔RTP快速退火爐
適用于4-12英寸硅片、第二代、第三代化合物材料等(包括但不限于磷化銦、砷化鎵、碳化硅、氮化鎵等各類襯底和外延片),擁有出色的熱源和雙腔結構設計,單次可處理兩片晶圓。
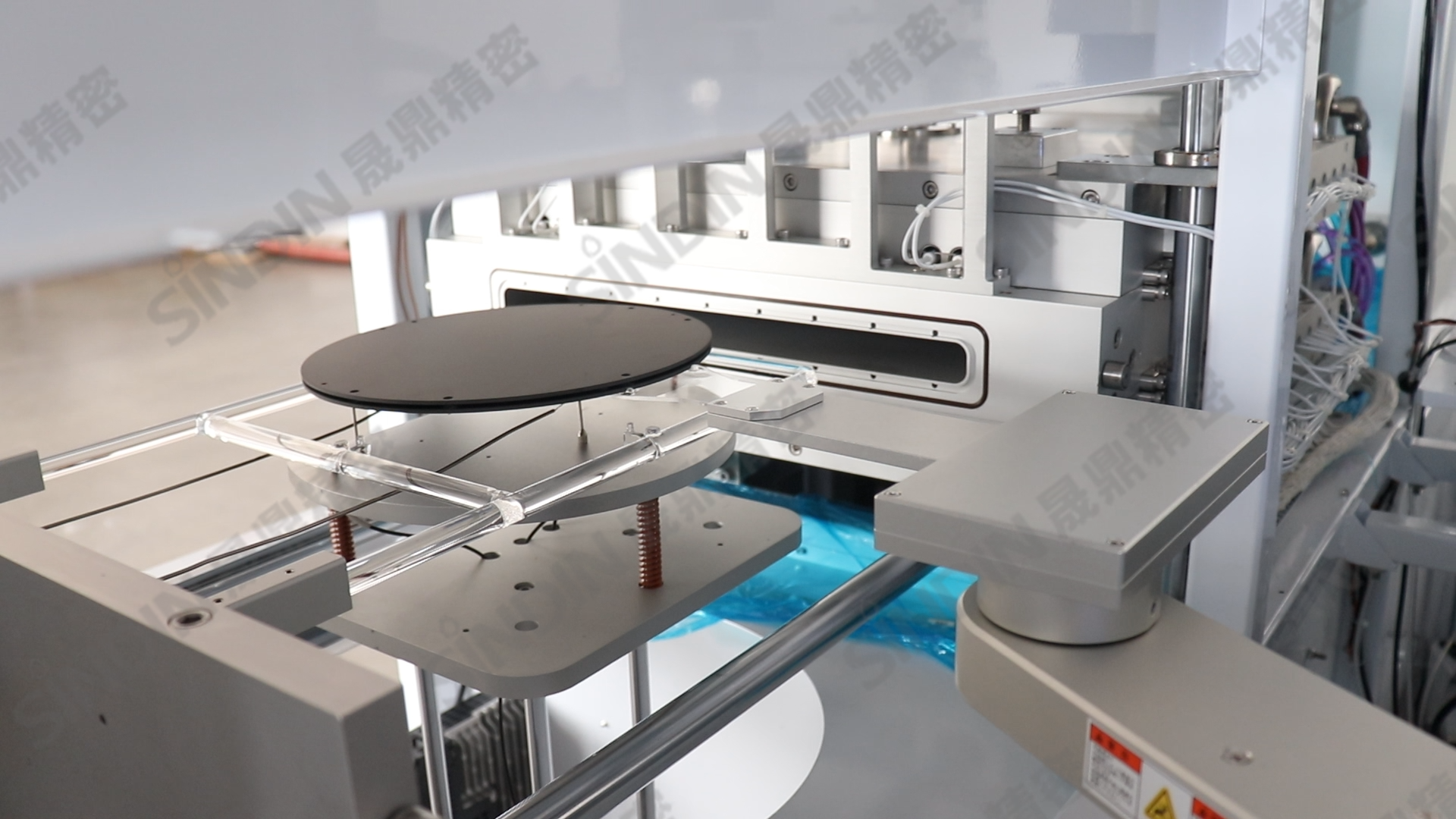
配置測溫系統,硅片在升溫、恒溫及降溫過程中精確地獲取晶圓表面溫度數據,誤差范圍控制在±1℃以內,保證良好的溫度重現性與溫度均勻性。

設備優勢
雙腔結構設計增加晶圓機器手,提高了生產效率
支持多種氣體氣氛,滿足不同材料的熱處理需求
工藝時間短,控溫精度高,具有極好的熱均勻性
具有三重安全保護措施,全方位保障儀器使用安全
行業應用
RTP快速退火爐是目前先進半導體工藝中非常重要的一種工藝設備,在氧化物/氮化物生長、離子注入、ITO鍍膜退火、歐姆接觸快速合金等工藝中得到了廣泛的應用:
①修復晶格損傷:離子注入后會產生位移原子、晶格點等晶格缺陷。快速退火可以修復晶格損傷,改善晶體內部結構,提高結晶質量。
②消除應力:晶體材料在制造過程中會產生一定程度的應力,快速退火有助于消除應力,提高半導體器件的電學性能和可靠性。
③歐姆接觸快速合金:通過改變材料的結構和性質,使金屬電極與半導體器件之間形成低接觸電阻,進而提高器件性能。